QR koodi

Tietoja meistä
Tuotteet
Ota meihin yhteyttä


Faksi
+86-579-87223657

Sähköposti

Osoite
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiangin maakunta, Kiina
Kemiallinen mekaaninen kiillotus (CMP) poistaa ylimääräiset materiaalit ja pintavirheet kemiallisten reaktioiden ja mekaanisen hankauksen yhteisvaikutuksen kautta. Se on keskeinen prosessi kiekon pinnan globaalin tasoittamisen saavuttamiseksi ja välttämätön monikerroksisissa kupariliitoksissa ja matalan k:n dielektrisissä rakenteissa. Käytännön valmistuksessa CMP ei ole täysin yhtenäinen poistoprosessi; se aiheuttaa tyypillisiä kuvioista riippuvia vikoja, joista merkittävimmät ovat hankaus ja eroosio. Nämä viat vaikuttavat suoraan liitoskerrosten geometriaan ja niiden sähköisiin ominaisuuksiin.
Dishing tarkoittaa suhteellisen pehmeiden johtavien materiaalien (kuten kuparin) liiallista poistamista CMP:n aikana, mikä johtaa maljan muotoiseen koveraan profiiliin yhden metalliviivan sisällä tai suurella metallialueella. Poikkileikkauksessa metalliviivan keskipiste on alempana kuin sen kaksi reunaa ja sitä ympäröivä dielektrinen pinta. Tämä ilmiö havaitaan usein leveillä viivoilla, tyynyillä tai lohkotyyppisillä metallialueilla. Sen muodostumismekanismi liittyy pääasiassa materiaalin kovuuden eroihin ja kiillotustyynyn muodonmuutokseen leveiden metalliosien yli: pehmeät metallit ovat herkempiä lietteessä oleville kemiallisille komponenteille ja hioma-aineille, ja tyynyn paikallinen kosketuspaine kasvaa leveillä ominaisuuksilla, jolloin poistonopeus metallin keskellä ylittää reunojen. Seurauksena on, että pesusyvyys yleensä kasvaa viivan leveyden ja ylikiillotusajan myötä.
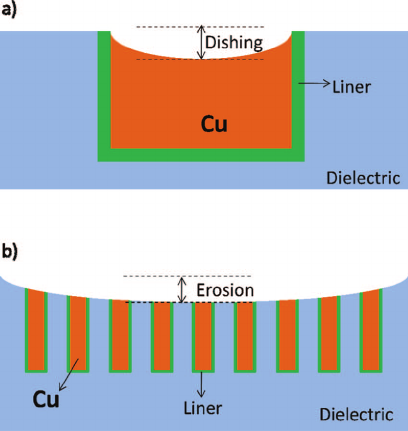
Eroosiolle on tunnusomaista se, että pinnan kokonaiskorkeus suuren kuviotiheyden alueilla (kuten tiheät metalliviivat tai alueet, joissa on tiheä valetäyttö) on pienempi kuin ympäröivillä harvoilla alueilla CMP:n jälkeen. Pohjimmiltaan se on kuviotiheyteen perustuvaa, aluetasoista materiaalin ylipoistoa. Tiheillä alueilla metalli ja dielektrisyys yhdessä muodostavat suuremman tehokkaan kosketuspinnan, ja tyynyn ja lietteen mekaaninen kitka ja kemiallinen vaikutus ovat vahvempia. Tästä johtuen sekä metallin että eristeen keskimääräiset poistumisnopeudet ovat korkeammat kuin pienitiheyksisillä alueilla. Kiillotuksen ja ylikiillotuksen edetessä metalli-dielektrinen pino tiheillä alueilla ohenee kokonaisuutena muodostaen mitattavissa olevan korkeusasteen, ja eroosion aste kasvaa paikallisen kuviotiheyden ja prosessikuormituksen myötä.
Laitteen ja prosessin suorituskyvyn näkökulmasta valuminen ja eroosio vaikuttavat puolijohdetuotteisiin moninkertaisesti. Dishing pienentää metallin tehollista poikkipinta-alaa, mikä johtaa korkeampaan liitäntäresistanssiin ja IR-pudotukseen, mikä puolestaan aiheuttaa signaalin viivettä ja pienentää ajoitusmarginaalia kriittisillä reiteillä. Eroosion aiheuttamat vaihtelut dielektrisen paksuuden vaihteluissa muuttavat metallilinjojen välistä loiskapasitanssia ja RC-viiveen jakautumista, mikä heikentää sirun sähköisten ominaisuuksien tasaisuutta. Lisäksi paikallinen dielektrinen oheneminen ja sähkökentän keskittyminen vaikuttavat metallien välisten eristeiden hajoamiskäyttäytymiseen ja pitkäaikaiseen luotettavuuteen. Integrointitasolla liiallinen pinnan topografia vaikeuttaa litografian tarkennusta ja kohdistusta, heikentää myöhemmän kalvon kerrostumisen ja syövytyksen tasaisuutta ja voi aiheuttaa vikoja, kuten metallijäämiä. Nämä ongelmat ilmenevät viime kädessä tuoton vaihteluna ja kutistuvana prosessiikkunana. Siksi käytännön suunnittelussa on välttämätöntä hallita tiskausta ja eroosiota määrätyissä rajoissa layouttiheyden tasaamisen ja optimoinnin avulla.kiillotus skiirehtiäselektiivisyys ja CMP-prosessiparametrien hienosäätö, jotta varmistetaan yhteenliittämisrakenteiden tasomaisuus, vakaa sähköinen suorituskyky ja vankka suurivolyymivalmistus.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiangin maakunta, Kiina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Kaikki oikeudet pidätetään.
Links | Sitemap | RSS | XML | Tietosuojakäytäntö |
